
PE03 Plasma-Therm ICP-Metal Etch
Process Runs
Control Charts

PE04 Plasma-Therm, Plasma Dielectric & Deep Silicon Etch
The PLASMA-THERM, formerly Oerlikon, plasma dielectric and DSE (Deep Silicon Etch) etcher is configured for etching films using fluorine based chemistries. Presently, SF6, CHF3, and C4F8 precursors are installed on the object. The object is equipped with a vacuum load-lock to prevent potentially toxic etch by-products from venting to the Cleanroom during sample load and unload.
Process Data
Control Charts
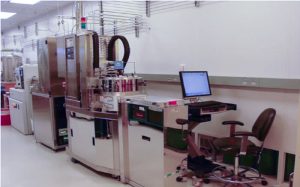
PE05 Plasma-Therm III-V’s Etcher
The Plasma-Therm III-V’s etcher is configured for etching III-V’s compound semiconductors using chlorine and fluorine based chemistries. Presently, Cl2, BCl3, HBr, CHF3, SF6, CH4, O2, N2, H2, He, and Ar are installed on the tool. The tool is capable of sample heating up to 180 C and is equipped with an end-point detection and thickness monitoring system.

March Asher
The March Asher, (PX-250), is a batch etch object designed for a multiplicity of plasma process applications. The electrodes and sample plates can be quickly rearranged to create direct plasma, reactive ion etch, and down stream plasma conditions for different applications. This system consists of three modules: a Reaction Chamber, a Process Controller Module and a solid state RF power generator. The reaction chamber is accessed by a double front door equipped with a window in the inner door for viewing the etch progress. The process controller monitors and sequences the variable parameters of the plasma process, including chamber pressure, RF power, process timing and gas flow rates. We normally operate the system in its Automatic mode, simply changing the parameter limits as needed.
At UTD, the system is normally used to “de-scum” photoresist with an O2 RIE plasma after develop and before etch to improve etch uniformity. Occasionally the electrodes are switched to create a direct plasma or a downstream plasma for chemical etching with little or no bombardment assist from the RIE configuration.

Trion Sirius-T2 RIE Etcher
This is our new reactive ion etch (RIE) tool! The RIE creates a directional, high energy gas plasma to etch materials. It is capable of etching with argon, oxygen, CF4, and SF6 chemistries.
This tool supports etch processes for both organic and inorganic materials.
